芯片制造工艺中的衡量指标
目录
- 一、芯片厂商
- 二、制程
- 2.1 最小栅极宽度(栅长)
- 2.2 制程越小越好
- 2.3 20nm制程的技术问题
- 2.4 10nm制程的技术问题
- 三、FinFET
- 四、半导体工艺的衡量指标
- 五、参考资料
- 六、延伸阅读
这篇博客主要解决两个问题:
1、芯片制造中常见的10nm/7nm/5nm制程是指什么的距离?
2、芯片制造工艺的先进行除了制程之外还有其它指标吗?
一、芯片厂商
目前芯片厂商有三类:IDM、Fabless、Foundry。
IDM(集成器件制造商) 指 Intel、IBM、三星这种拥有自己的晶圆厂,集芯片设计、制造、封装、测试、投向消费者市场五个环节的厂商,一般还拥有下游整机生产。
Fabless(无厂半导体公司) 则是指有能力设计芯片架构,但本身无厂,需要找代工厂代为生产的厂商,知名的有 ARM、NVIDIA、高通、苹果和华为。
Foundry(代工厂) 则指台积电和 GlobalFoundries(格芯GF),拥有工艺技术代工生产别家设计的芯片的厂商。我们常见到三星有自己研发的猎户座芯片,同时也会代工苹果 A 系列和高通骁龙的芯片系列,而台积电无自家芯片,主要接单替苹果和华为代工生产。
集成电路制造过程中,光刻工艺是最直接体现其工艺先进程度的技术。其中光刻技术的分辨率是指光刻系统所能分辨和加工的最小线条尺寸,决定了CPU中的晶体管最小特征尺寸。


ASML NXE-3350B光刻系统
NXE-3350B是ASML生产的EUV光刻设备,EUV光刻是一种极紫外光刻(Extreme Ultra-violet),它以波长为10-14纳米的极紫外光作为光源的光刻技术。具体为采用波长为13.4nm 的紫外线。极紫外线就是指需要通过通电激发紫外线管的K极然后放射出紫外线。
之所以选用紫外线是因为目前可知且安全的最小波长。(排序从大到小为无线电波、微波、红外线、可见光、紫外线、X射线、γ射线。)
二、制程
根据ITRS《国际半导体技术蓝图》里面的相关规定,平常说说的16nm、14nm、10nm就是用来描述半导体制程工艺的节点代数,针对不同的对象,这些参数实际表示的间距含义是不同的。 在DRAM中,可能是描述在DRAM Cell中两条金属线间最小允许间距Pitch值的一半长度Half-Pitch半节距长度;而用在CPU上时,可能描述的则是CPU晶体管中最小栅极线宽。
以下说明的是CPU制程。
2.1 最小栅极宽度(栅长)
制程一般以特征尺寸来体现,所谓的特征尺寸就是原胞中的最小尺寸,通常以栅极的宽度来表征。因此常说的制程是多少纳米,其实质就是栅极的最小宽度是对应的纳米数。
一个晶体管(场效应管)结构大致如下:


图中晶体管中,Gate(栅极)与P型半导体材料之间为绝缘氧化层材料(一般为二氧化硅),Source(源极)和Drain(漏极)连接N型半导体材料, P型半导体材料多子为带正电的空穴,N型半导体材料多子为带负电的自由电子,后面有个“+”号表示电子占绝对主导地位。电流从源极流入漏级,栅极相当于闸门,主要负责控制两端源极和漏级的通断。
源极和漏极之间由于是P型材料,所以当栅极不通电时,源极的电子穿过P型材料时,电子与P型材料中的空穴中和,电子就无法到达漏极,即源极和漏极处于断路状态,表示状态0。
当栅极通电时,将P型材料中带负电的电子吸到栅极附近(虽然P型材料中的电子不多),形成一个通道,这样源极的电子就不会被中和,使得源极的电子能顺利到达漏极,即源极和漏极处于连接状态,表示状态1。
从源极到漏极,电流会损耗,而栅极的宽度则决定了电流通过时的损耗,表现出来就是手机常见的发热和功耗,宽度越窄,功耗越低。而栅极的最小宽度(栅长),就是 XX nm工艺中的数值。上图中的L就是栅极的宽度。L越短表示电流可以用更短的路径从 Source 端到 Drain 端。
2.2 制程越小越好
1、增加收益。栅长越小,那么单个晶体管就越小,则做出来的CPU die面积就越小,相同大小的晶圆就能生产出更多的CPU die。(什么是CPU die?)
2、提高性能。栅长越小,说明在相同面积的CPU die上可以集成更多的晶体管,那么CPU的性能也会得到提升。(这不是绝对的,还与CPU的设计有关)
3、降低功耗。 栅长变小,那么工作电压会相应降低,CPU的功耗也会随之降低。
4、提高CPU主频。 在更先进的工艺下,晶体管截止频率上会有更好表现,CPU也自然能工作在更高的频率上。
2.3 20nm制程的技术问题
当栅极宽度逼近 20nm 时,栅极对电流控制能力急剧下降,出现“电流泄露”问题。为了在 CPU 上集成更多的晶体管,二氧化硅绝缘层会变得更薄,只有几个原子那么厚,那么这个时候对于晶体管来说是十分不稳定的,会导致电子随意穿过壁垒导致漏电,导致芯片功耗增加。
电流泄露将会导致:功耗的提高和信号模糊。
1、电流泄露将直接增加芯片的功耗,为晶体管带来额外的发热量;
2、电流泄露导致电路错误,信号模糊。为了解决信号模糊问题,芯片又不得不提高核心电压,功耗增加,陷入死循环。
因而,漏电率如果不能降低,CPU 整体性能和功耗控制将十分不理想。之前台积电产能跟不上很大原因就是用上更高制程时遭遇了漏电问题。
解决方案:
Intel弄出了高介电常数薄膜(High-k Dielectric)和金属门集成电路,以及耳熟能详的FinFET鳍式场效晶体管结构,通过增加绝缘层表面积来增加电容值,以此降低漏电流大小的问题。
2.4 10nm制程的技术问题
当晶体管的尺寸缩小到一定程度(业内认为小于 10nm)时会产生量子隧穿效应,这时晶体管的特性将很难控制,芯片的生产难度就会成倍增长。
在经典物理中,宏观粒子的能量小于势垒高度时,这个粒子是不可能穿过这个势垒,但是对于微观粒子,此时具有波粒二象性,神奇的量子效应就出现了,即便是能量低于势垒高度,仍有一定的概率可以突破势垒。
这要就造成一个大问题,这个电子到底过去了没有,监测到没有,逻辑门该输出0还是1,答案不知道,那么CPU就不能正常工作,因此要杜绝这个问题发生。
由于量子隧穿效应导致良品率较低,所以骁龙 835 出货时间推迟,X30 遥遥无期。另外,骁龙 835 用上了 10nm 的制程工艺,设计制造成本相比 14nm 工艺增加接近 5 成。
Intel、台积电、三星等半导体制造前沿企业均已经针对这个问题进行了研究,依然有一些措施可以防止量子隧穿效应的出现。
三、FinFET
业界主流芯片还停留在 20/22nm 工艺节点上的时候,Intel 就率先引入了 3D FinFET 这种技术。后来三星和台积电在 14/16nm 节点上也大范围用上了类似的 FinFET 技术。
FinFET(Fin Field-Effect Transistor)称为鳍式场效应晶体管,是一种新的晶体管,称为 CMOS。具体一点就是把芯片内部平面的结构变成了3D,把栅极形状改制,增大接触面积,减少栅极宽度的同时降低漏电率,而晶体管空间利用率大大增加。目前已经被大规模应用到手机芯片上。图中左边为平面型,右边为FinFET。
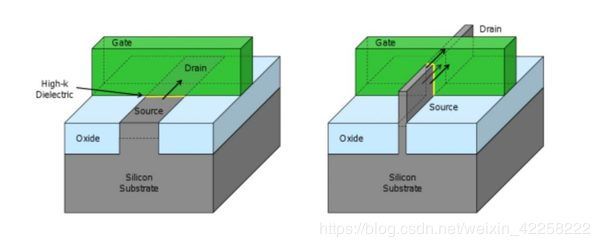
LPE/LPP/LPC/LPU 又是什么?
在工艺分类上,芯片主要分两大类:
HP(High Performance): 主打高性能应用范畴;
LP(Low Power): 主打低功耗应用范畴。
满足不同客户需求,HP 内部再细分 HPL、HPC、HPC+、HP 和 HPM 五种。
HP 和 LP 之间最重要区别就在性能和漏电率上,HP 在主打性能,漏电率能够控制在很低水平,芯片成本高;LP 则更适合中低端处理器使用,因为成本低。
芯片除了在制程上寻求突破,工艺上也会逐步升级。
四、半导体工艺的衡量指标
下表是三星和台积电对7nm制程的定义, MTr/mm2指的是每平方毫米有几百万个晶体管。
| Process | Samsung 7LPP | TSMC 7FF | TSMC 7FF+ |
|---|---|---|---|
| 晶体管密度 | 63 MTr/mm2 (1.4c×Qualcomm Centriq 10nm density) | 83 MTr/mm2 (Apple A12) | |
| 最小金属间距 | 46 nm | 40 nm | <40 nm |
| EUV implementation | Replace quad-pattered metal: 20% of total layer set | None | 4 layers |
| EUV-limited wafer output | 1500 wafers/day | N/A | ~1000wafers/day |
注:表中的晶体管密度与具体芯片的型号有一定关系。据悉,三星7nm工艺是每平方毫米1.0123亿个。至于台积电、GF两家的7nm,晶体管密度比三星要低一些。
从表中的数据可知,不同的公司对于7nm制程的定义时有区别的,一个芯片的工艺先进性不能只通过多少纳米制程来判断。
线宽(栅长)仅仅代表工艺节点,但要衡量这个工艺的好坏,Gate Pitch栅极间距,Fin Pitch鳍片间距、Minimum Metal Pitch最小金属间距、Logic Cell Height逻辑单元高度(逻辑单元高度低,在3D堆叠上更有优势) 的参数更具参考意义。


Intel 执行副总裁兼制造、运营和销售集团总裁 Smith 表示,目前业界经常用 16 纳米、14 纳米、10 纳米等制程节点数字来衡量半导体行业的工艺发展,这些数字的确曾经有它真实的物理意义,但现在却并非如此。实际上,Smith 给出了另外一个衡量性能的指标:Transistor Density晶体管密度。
Intel处理器架构与集成部门主管、高级院士Mark Bohr提出以晶体管密度来衡量半导体工艺水平。
为了提升晶体管密度,在推动制程工艺前进的同时,Intel在 14 纳米制程中采用了鳍式场效应晶体管(FinFET)和超微缩技术(Hyper Sacling),其中超微缩技术能够让 14 纳米和 10 纳米上的晶片面积缩小了 0.5 倍以上。
10纳米技术密度对比:
| 英特尔(10nm) | TSMC(10nm) | 三星(10nm) | |
|---|---|---|---|
| 鳍片间距 | 34 nm | 36 nm | 42 nm |
| 栅极间距 | 54 nm | 66 nm | 68 nm |
| 最小金属间距 | 36 nm | 42 nm | 48 nm |
| 逻辑单元高度 | 272 nm | 360 nm | 420 nm |
| 逻辑晶体管密度 | 100.8 MTr/mm2 | 48.1 MTr/mm2 | 51.6 MTr/mm2 |
晶体管密度越大,意味着在同等的空间内,能容纳更多的晶体管,晶体管越多,则芯片内的处理运算单元越强,芯片的处理能力越强。晶体管密度越大,说明晶体管之间的距离越近,电子在移动中的损耗也越小,功耗也能得到提升。
五、参考资料
[1]: 简单来说,我们常听到的 22nm、14nm、10nm 究竟是什么意思?
[2]: 超能课堂(135):纳米制程背后的真真假假
[3]: 摩尔定律永不过时?Intel 全球首发 10 纳米技术,并正面怼上了三星、台积电
[4]: 半导体全面分析(四):晶圆四大工艺,落后两代四年!
[5]: Intel 10nm工艺揭秘:晶体管密度比肩台积电/三星7nm
[6]: 意大利炮(面)来了?深度解析Intel初代10nm Cannon Lake处理器
六、延伸阅读
[1]: 半导体全面分析(一):两大特性,三大政策,四大分类!
[2]: 半导体全面分析(二):设计两大巨头、EDA三分天下、四大指令集!
[3]: 半导体全面分析(五):先进封装,验证检测,并道超车!