基于区域划分的GaN HEMT 准物理大信号模型
GaN HEMT器件的大信号等效电路模型分为经验基模型和物理基模型。经验基模型具有较高精度但参数提取困难,特别在GaN HEMT器件工艺不稳定的情况下不易应用。相比之下,物理基模型从器件工作机理出发,参数提取相对方便,且更容易更新和维护。在GaN HEMT器件标准化过程中,选择了基于表面势和基于电荷控制的物理基大信号模型。然而,这些模型仍存在方程复杂、收敛性差、精度不足等问题。基于区域划分的可缩放大信号模型,兼顾了简单性和精度,并考虑了自热效应、高低温效应、陷阱效应等。该模型在不同栅宽的GaN HEMT器件上得到了验证,显示出良好的小信号和大信号性能。
区域划分建模原理
区域划分建模方法是一种基于器件沟道中电场和载流子分布的模拟方法,将沟道划分为相邻的区域。在每个区域内,使用相应的物理方程描述电流-电压关系,考虑器件的主要工作原理。通过确保电流、电压、电场等物理量在各区域边界的连续性,将各区域的方程联立求解,得到器件的最终I-V特性。
该建模方法最早在20世纪80年代应用于MODFET器件的建模。随着第三代半导体材料和器件的发展,这种建模方法在21世纪初开始用于AlGaN/GaN HFET器件。从2006年起,美国北卡罗来纳州立大学的Robert Trew团队对区域划分模型进行了深入研究,并提出了可用于大信号仿真的区域划分大信号模型。这一模型结合了物理基模型和经验基模型的优势,既反映了器件的物理机理,又能够集成于电路仿真软件中进行大信号谐波平衡仿真。从理论上讲,这种模型在器件和电路的设计与分析中都具有应用前景。以下对区域划分建模原理进行简要介绍。
依据器件工作时沟道中电场和载流子的分布,可以将沟道划分为不同的区域。
器件工作于线性区:
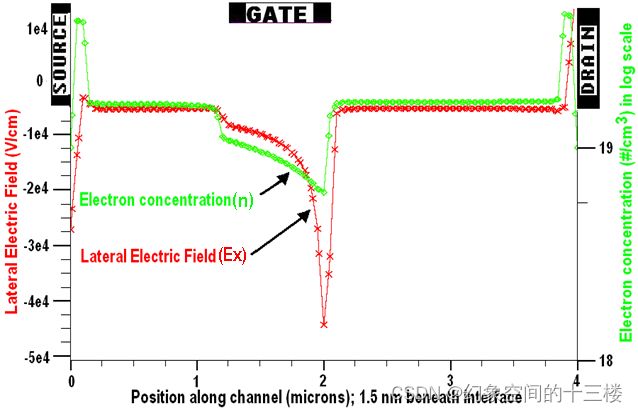
在线性区可以将器件划分为三个区域,分别是源极接入区(Source Neutral Zone,SNZ, Z1);占据栅下全部区域的本征FET区(Intrinsic FET Zone,IFZ, Z2)和漏极接入区 (Drain Neutral Zone,DNZ, Z5)。
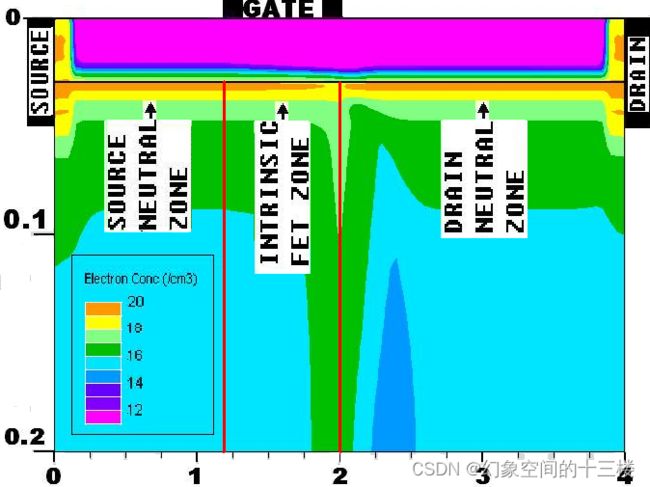
器件工作于饱和区:

在饱和区,可以将器件划分为五个区域。分别是源极接入区 (SNZ, Z1);占据栅下源端部分区域的本征接入区(IFZ, Z2) ; 占据栅下剩余部分的空间电荷聚集区(Space-charge Limited Zone,SLZ, Z3);占据始于栅极漏端的部分漏极接入区的电荷耗尽区(Charge Deficit Zone,CDZ, Z4)和漏极接入区 (Drain Neutral Zone,DNZ,Z5)。

当器件工作于线性区时,在源极接入区和漏极接入区,量子阱被电子填满,电子速度最小。在本征FET区,电子漂移速度增加,但仍小于电子饱和速度vsat。在源极接入区和漏极接入区,由电场-电子速度关系可得:
ν = μ E ( 1 + ( E / E c ) β ) 1 / β ( 1 ) \nu=\frac{\mu E}{\left(1+\left(E/E_c\right)^{\beta}\right)^{1/\beta}}(1) ν=(1+(E/Ec)β)1/βμE(1)、
由(1)式可得:
E = E c ( 1 − ( ν s a t / ν ) β ) 1 / β ( 2 ) E=\frac{E_c}{(1-(\nu_{\mathrm{sat}}/\nu)^\beta)^{1/\beta}}(2) E=(1−(νsat/ν)β)1/βEc(2)
其中μ为低场电子迁移率,Ec为电子速度饱和时的临界电场,vsat为电子饱和速度,β为电场-电子速度关系的阶数,通常β = 2。
这里的β为拟合值
由式(2)可进一步得到源极接入区和漏极接入区的电场如下:
E s = E c I I s a t β − I β β ( 3 ) E_s=\frac{E_cI}{\sqrt[\beta]{I_{sat}^\beta-I^\beta}}(3) Es=βIsatβ−IβEcI(3)
其中Isat为饱和电流。根据器件工作在线性区时沟道中电场的分布,电场在源极接入区和漏极接入区可被视为常数,可以根据电场与电势的关系,得到栅极源端和栅极漏端的电压如下:
V s i = E c l s I ( I s a t β − I β ) 1 / β ( 4 ) V_{si}=\frac{E_{c}l_{s}I}{\left(I_{sat}^{\beta}-I^{\beta}\right)^{1/\beta}}(4) Vsi=(Isatβ−Iβ)1/βEclsI(4)
这里的I应为Isi(Z1中电流的解析解),参考原式:
V s i = E c L s I s i ( I max β − I s i β ) 1 / β . V_{si}=\frac{E_{c}L_{s}I_{si}}{\left(I_{\max}^{\beta}-I_{si}^{\beta}\right)^{1/\beta}}. Vsi=(Imaxβ−Isiβ)1/βEcLsIsi.
V d i = V d − E c l d I ( I s a t β − I β ) 1 / β ( 5 ) V_{di}=V_d-\frac{E_cl_dI}{\left(I_{sat}^\beta-I^\beta\right)^{1/\beta}}(5) Vdi=Vd−(Isatβ−Iβ)1/βEcldI(5)
这里的I应为Ids,参考原式:
V d i = V d − E c ( L d − L 4 ) I d s ( I max β − I d s β ) 1 / β − 1 2 L 4 2 k 4 , V_{di}=V_d-\frac{E_c(L_d-L_4)I_{ds}}{\left(I_{\max}^\beta-I_{ds}^\beta\right)^{1/\beta}}-\frac12L_4^2k_4, Vdi=Vd−(Imaxβ−Idsβ)1/βEc(Ld−L4)Ids−21L42k4,
其中 Vsi 和 Vdi 分别为栅极源端和栅极漏端的电压,ls 和ld 分别为源极接入区和漏极接入区的长度,Vd 为漏极偏置电压。
在本征FET 区,根据缓变沟道近似,载流子浓度满足如下关系:
n s ( x ) = C e f f q ( V g t − V ( x ) ) ( 6 ) n_s(x)=\frac{C_{eff}}q(V_{gt}-V(x))(6) ns(x)=qCeff(Vgt−V(x))(6)
其中ns(x)为位置x 处的载流子浓度,Ceff 为有效势垒电容,Vgt =Vgs - Vpinch,V(x)为位置 x 处的电势。将式(1),(6)两式和电场与电势的关系E(x)= -dV/dx 代入漏极电流Ids 的基本表达式:
I d s = W q n s ( x ) ν ( x ) ( 7 ) I_{ds}=Wqn_s(x)\nu(x)(7) Ids=Wqns(x)ν(x)(7)
其中W 为器件的栅宽,q 为电子电荷,v(x)为位置x 处的电子速度。整理后,可得漏极电流Ids 的表达式如下:
( x − l s ) I d s = ∫ V s i V ( x ) ( ( W μ C e f f ( V g t − V ′ ) ) β − ( I d s E c ) β ) 1 / β d V ′ ( 8 ) \left.(x-l_s)I_{ds}=\int_{V_{si}}^{V(x)}\left(\begin{array}{c}(W\mu C_{eff}\left(V_{gt}-V^{\prime}\right))^{\beta}-(\frac{I_{ds}}{E_{c}})^{\beta}\\\end{array}\right.\right)^{1/\beta}dV^{\prime}(8) (x−ls)Ids=∫VsiV(x)((WμCeff(Vgt−V′))β−(EcIds)β)1/βdV′(8)
将式(8)在栅下整个区域积分,则式(8)可化为如下形式:
l g I d s = ∫ V s i V d i ( ( W μ C e f f ( V g t − V ) ) β − ( I d s E c ) β ) 1 / β d V ( 9 ) {l}_gI_{ds}=\int_{V_{si}}^{V_{di}}\left(\left(W\mu {C}_{eff}\left(V_{gt}-V\right)\right)^\beta-\left(\frac{I_{ds}}{E_{c}}\right)^\beta\right)^{1/\beta}dV(9) lgIds=∫VsiVdi((WμCeff(Vgt−V))β−(EcIds)β)1/βdV(9)
其中lg 为栅长。再将式(4)和式(5)中的Vsi 和Vdi 代入式(9),求解该积分方程,即可得到器件工作于线性区时的漏极电流Ids。
以上式子中需要实际测试的物理量有:
(4)式中需要测试的物理量
| 需要测试的量 | 含义 |
|---|---|
| Ec | 电子速度饱和时的临界电场 |
| ls | 源极接入区长度 |
| Isat | 电流比例因子 |
(5) 式中需要测试的物理量
| 需要测试的量 | 含义 |
|---|---|
| Ec | 电子速度饱和时的临界电场 |
| Vd | 漏极偏置电压 |
| ld | 漏极接入区的长度 |
(9)式中需要测试的物理量
| 需要测试的量 | 含义 |
|---|---|
| lg | 栅长 |
| W | 栅宽 |
| Ceff | 有效势垒电容 |
| Vgt | 有效栅极电压 |
| Ec | 电子速度饱和时的临界电场 |
以上式子中需要拟合的量有:
| 需要拟合的量 | 含义 |
|---|---|
| β | 电场-电子速度关系的阶数 |
当器件工作于饱和区时,栅极漏端开始出现耗尽区,耗尽区向器件的源端延长形成空间电荷聚集区,向器件的漏端延长形成电荷耗尽区。空间电荷聚集区和电荷耗尽区的长度随漏极偏置电压的增大而变长。由器件工作于饱和区的电场分布,可认为空间电荷聚集区和电荷耗尽区的电场随位置 x 线性变化,即电场对坐标的导数dEx/dx为常数。因此在空间电荷聚集区和电荷耗尽区可应用泊松方程。在空间电荷聚集区,电场满足如下关系:
d E x d x = q ε n s z = I ε × W × ν s a t × t = k 3 ( 10 ) \frac{dE_x}{dx}=\frac q\varepsilon n_{sz}=\frac I{\varepsilon\times W\times\nu_{sat}\times t}=k_3(10) dxdEx=εqnsz=ε×W×νsat×tI=k3(10)
其中t为沟道深度,可认为t与电流成正比,则t满足如下关系:
t t G a N = I I s a t ( 11 ) \begin{aligned}\frac{t}{\boldsymbol{t}_{GaN}}&=\frac{I}{\boldsymbol{I}_{sat}}\end{aligned}(11) tGaNt=IsatI(11)
其中 tGaN 为GaN层的厚度。将式(11)代入式(10),则有:
d E x d x = q ε n S L Z = I s a t ε × W × ν s a t × t G a N = k 3 ( 12 ) \frac{dE_x}{dx}=\frac q\varepsilon n_{_{SLZ}}=\frac{I_{sat}}{\varepsilon\times W\times\nu_{_{sat}}\times t_{_{GaN}}}=k_{_3}(12) dxdEx=εqnSLZ=ε×W×νsat×tGaNIsat=k3(12)
在电荷耗尽区,电场满足如下关系:
d E x d x = q n s s ε T − I ε × W × ν s a t × T + q N ε = q ε T ( n s s − 1 q × W × ν s a t + N T ) = k 4 ( 13 ) \begin{aligned} \Large\frac{dE_x}{dx}& =\frac{qn_{ss}}{\varepsilon T}-\frac I{\varepsilon\times W\times\nu_{sat}\times T}+\frac{qN}\varepsilon \\ &=\frac q{\varepsilon T}\left(n_{_{ss}}-\frac1{q\times W\times\nu_{_{sat}}}+NT\right)=k_4 \end{aligned}(13) dxdEx=εTqnss−ε×W×νsat×TI+εqN=εTq(nss−q×W×νsat1+NT)=k4(13)
其中nss为AlGaN/GaN交界面处的极化面电荷密度,T为器件的厚度,N为有效掺杂浓度,N的定义如下:
N = 1 T ∫ T N ( y ) d y ( 14 ) N=\frac1T\int_TN(y)dy(14) N=T1∫TN(y)dy(14)
根据电场的连续性,在本征 FET 区和空间电荷聚集区的交界处,电场等于电子速度饱和时的临界电场Ec,电势为Vc;在空间电荷聚集区和电荷耗尽区的交界处,电场等于栅极漏端的电场Edi,电势为Vdi;在电荷耗尽区和漏极接入区的交界处,电场即为式(3)。设空间电荷聚集区和电荷耗尽区的长度分别为l3 和l4,空间电荷聚集区和电荷耗尽区电场随位置的变化率dEx/dx 分别为k3 和k4,则有:
E d i = E c + k 3 l 3 ( 15 ) E_{di}=E_c+k_3l_3(15) Edi=Ec+k3l3(15)
E d i = E s + k 4 l 4 ( 16 ) E_{di}=E_s+k_4l_4(16) Edi=Es+k4l4(16)
V d i = V d − E c l d I ( I s a t β − I β ) 1 / β − 1 2 l 4 2 k 4 ( 17 ) V_{di}=V_{d}-\frac{E_{c}l_{d}I}{\left(I_{sat}^{\beta}-I^{\beta}\right)^{1/\beta}}-\frac12l_{4}^{2}k_{4}(17) Vdi=Vd−(Isatβ−Iβ)1/βEcldI−21l42k4(17)
V c = V d i − 1 2 l 3 2 k 3 ( 18 ) V_c=V_{di}-\frac12l_3^2k_3(18) Vc=Vdi−21l32k3(18)
l3 由下式给出:
l 3 = l g − β l g 2 I [ ( V g t − V s i ) ( V g t − V s i ) β − ( I β E c l s ) β β − β l g 2 I [ ( I β E c l s ) β ln ( I β E c l s V g t − V s i − ( V g t − V s i ) β − ( I β E c l s ) β β ) ] ( 19 ) \begin{aligned} l_{3}=& l_g\left.-\frac{\beta l_g}{2I}\right[(V_{gt}-V_{si})\sqrt[\beta]{(V_{gt}-V_{si})^\beta-\left(\frac I{\beta E_{c}l_{s}}\right)^\beta} \\ &\left.\left.-\frac{\beta l_\mathrm{g}}{2I}\right[\left(\frac I{\beta E_cl_s}\right)^\beta\ln\left(\frac{\frac I{\beta E_cl_s}}{V_{\mathbf{g}t}-V_{si}-\sqrt[\beta]{(V_{\mathbf{g}t}-V_{si})^\beta-\left(\frac I{\beta E_cl_s}\right)^\beta}}\right)\right] \end{aligned}(19) l3=lg−2Iβlg[(Vgt−Vsi)β(Vgt−Vsi)β−(βEclsI)β−2Iβlg[(βEclsI)βln Vgt−Vsi−β(Vgt−Vsi)β−(βEclsI)ββEclsI (19)
将式(9)中的lg 替换为lg- l3,Vdi 替换为Vc,即可得到器件在饱和区工作时本征 FET 区的漏极电流Ids 方程如下:
( l g − l 3 ) I d s = ∫ V s i V c ( ( W μ C e f f ( V g t − V ) ) β − ( I d s E c ) β ) 1 / β d V ( 20 ) (l_{\mathrm{g}}-l_{3})I_{d\mathrm{s}}=\int_{V_{\mathrm{si}}}^{V_{c}}\left(\left(W\mu C_{eff}\left(V_{\mathrm{g}t}-V\right)\right)^{\beta}-\left(\frac{I_{d\mathrm{s}}}{E_{c}}\right)^{\beta}\right)^{1/\beta}dV(20) (lg−l3)Ids=∫VsiVc((WμCeff(Vgt−V))β−(EcIds)β)1/βdV(20)
求解式(20)即可得到饱和区的漏极电流Ids。
以上式子中需要实际测试的物理量有:
(18)式中需要测试的物理量
| 需要测试的量 | 含义 |
|---|---|
| Vdi | 栅极漏端 |
| l3 | 空间电荷聚集区长度 |
| k3 | 空间电荷聚集区电场随位置的变化率 |
(19)式中需要测试的物理量
| 需要测试的量 | 含义 |
|---|---|
| lg | 栅长 |
| Vgt | 有效栅极电压 |
| Ec | 电子速度饱和时的临界电场 |
| ls | 源极接入区长度 |
| Vsi | 栅极源端 |
(20)式中需要测试的物理量
| 需要测试的量 | 含义 |
|---|---|
| lg | 栅长 |
| l3 | 空间电荷聚集区长度 |
| Vc | 电场等于电子速度饱和时的电势 |
| W | 栅宽 |
| Ceff | 有效势垒电容 |
| Vgt | 有效栅极电压 |
| Ec | 电子速度饱和时的临界电场 |
以上式子中需要拟合的量有:
| 需要拟合的量 | 含义 |
|---|---|
| β | 电场-电子速度关系的阶数 |
基于区域划分的准物理大信号模型建模
原始的区域划分模型存在一些局限性,未考虑到GaN HEMT器件的自热效应、高低温效应和陷阱效应。该模型推导的漏极电流方程对Ids是一种隐形表达式,需要通过数值方法求解积分方程式(4-9)和式(4-20)才能获取。而为了嵌入电路仿真软件进行设计和分析,紧凑大信号模型需要漏极电流Ids关于栅压Vgs和漏压Vds的显性解析表达式。因此,为了兼顾这些考虑,必须进行专门的研究。
下图展示了基于区域划分的漏极电流Ids建模的流程。

首先推导模型的基本方程并从室温下的直流I-V测试数据中提取相关参数。接着,利用高低温I-V测试数据对自热效应和高低温效应进行建模并提取相关参数。然后,通过多静态偏置下的脉冲I-V测试数据对陷阱效应进行建模并提取相关参数。最终,通过这一建模流程,得到了可缩放的、能够准确反映GaN HEMT器件自热效应、陷阱效应和高低温效应的漏源电流Ids模型。
漏源电流Ids 模型基本方程推导
当GaN HEMT 器件工作于线性区时,电子从源极到漏极的路径可被分为源极接入区Z1, 本征FET 区Z2 和漏极接入区Z3 三个区域。

此时器件的漏极电流Ids 可通过将栅极源端电压Vsi 的表达式(4)和栅极漏端电压Vdi 的表达式(5)代入式(9),并求解积分方程得到。由于式(4)和式(5)中的Isat 仅表示固定栅压下的饱和电流,为了推导出全栅压偏置下的漏极电流Ids 表达式,需将式(4)和式(5)修正如下:
V s i = E c l s I d s I m a x β − I d s β β ( 21 ) V_{si}=\frac{E_cl_sI_{ds}}{\sqrt[\beta]{I_{max}^{\beta}-I_{ds}^{\beta}}}(21) Vsi=βImaxβ−IdsβEclsIds(21)
V d i = V d s − E c l d I d s I m a x β − I d s β β ( 22 ) V_{di}=V_{ds}-\frac{E_cl_dI_{ds}}{\sqrt[\beta]{I_{max}^\beta-I_{ds}^\beta}}(22) Vdi=Vds−βImaxβ−IdsβEcldIds(22)
其中Imax 是所加栅极偏置电压下器件的最大电流。Imax 可以写为如下形式:
I m a x = W q n s ( V g s ) ν m a x ( 23 ) I_{max}=Wqn_s\left(V_{gs}\right)\nu_{max}(23) Imax=Wqns(Vgs)νmax(23)
其中W 为器件的栅宽,q 为电子电荷,vmax 是器件的最大电子饱和速度。ns(Vgs)是电子面密度,它是关于栅极偏置电压Vgs 的函数。ns(Vgs)可以通过求解基于表面势建模方法的以下基本方程得到:
n s = D V t h [ l n ( 1 + e E f − E 0 V t h ) + l n ( 1 + e E f − E 1 V t h ) ] ( 24 ) n_s=DV_{th}\left[ln\left(1+e^{\frac{E_f-E_0}{V_{th}}}\right)+ln\left(1+e^{\frac{E_f-E_1}{V_{th}}}\right)\right](24) ns=DVth[ln(1+eVthEf−E0)+ln(1+eVthEf−E1)](24)
E 0 , 1 = γ 0 , 1 n s 2 / 3 ( 25 ) E_{_{0,1}}={\gamma_{0,1}}{n_s}^{2/3}(25) E0,1=γ0,1ns2/3(25)
n s = C e f f q ( V g o − E f ) ( 26 ) n_s=\frac{C_{eff}}q(V_{go}-E_f)(26) ns=qCeff(Vgo−Ef)(26)
其中 D 为态密度,Vth 为热电压,Ef 为费米能级,E0 和E1 分别为量子阱内的第一和第二能级,γ0 和γ1 为通过实验测得的参数。Vgo = Vgs - Voff,其中夹断电压Voff 可通过如下方程计算得到:
V o f f = ϕ B ( x ) − Δ E c ( x ) − q N d d 2 2 ε A l G a N − q σ d ε A l G a N ( 27 ) V_{off}=\phi_B(x)-\Delta E_c(x)-\frac{qN_dd^2}{2\varepsilon_{AlGaN}}-\frac{q\sigma d}{\varepsilon_{AlGaN}}(27) Voff=ϕB(x)−ΔEc(x)−2εAlGaNqNdd2−εAlGaNqσd(27)
其中x 为铝组分,φB(x)为肖特基势垒高度,ΔEc(x)为AlGaN 和GaN 之间的导带不连续性。φB(x)和ΔEc(x)均为铝组分x 的函数,可按如下方程计算:
ϕ B ( x ) = ( 1.3 x + 0.84 ) e V ( 28 ) \phi_B(x)=\left(1.3x+0.84\right)eV(28) ϕB(x)=(1.3x+0.84)eV(28)
Δ E c ( x ) = 0.7 [ E g ( x ) − E g ( 0 ) ] ( 29 ) \Delta E_c(x)=0.7\left[E_g(x)-E_g(0)\right](29) ΔEc(x)=0.7[Eg(x)−Eg(0)](29)
E g ( x ) = x E g ( A l N ) + ( 1 − x ) E g ( G a N ) − x ( 1 − x ) 1.0 e V = x 6.13 e V + ( 1 − x ) 3.42 e V − x ( 1 − x ) 1.0 e V ( 30 ) \begin{gathered} E_{\mathfrak{g}}(x) =xE_g(\mathrm{AlN})+(1-x)E_g(\mathrm{GaN})-x(1-x)1.0\mathrm{~eV} \\ =x6.13\mathrm{~eV}+(1\mathrm{-}x)3.42\mathrm{~eV}\mathrm{-}x(1\mathrm{-}x)1.0\mathrm{~eV} \end{gathered}(30) Eg(x)=xEg(AlN)+(1−x)Eg(GaN)−x(1−x)1.0 eV=x6.13 eV+(1−x)3.42 eV−x(1−x)1.0 eV(30)
Nd 是AlGaN 层的掺杂浓度。σ 是极化引入的面电荷密度。
来源:闻彰.微波GaN HEMT大信号模型参数提取研究[D].导师:徐锐敏.电子科技大学,2018.