PCB板材组成详解
覆铜板,又名PCB基材(见下图)
将增强材料(玻璃纤维布)浸以环氧树脂(pp片),一面或两面覆以铜箔,经热压而成的一种板状材料,称为覆铜箔层压板(Copper CladLaminates,简称CCL)。
它是做PCB的基本材料,常叫它板材。当它用于多层板生产时,也叫芯板(CORE)。构成覆铜板(PCB板材)的三种原材料:铜箔(皮),树脂(筋),增强材料(骨)。

本篇文章我们主要介绍下,组成板材的三种材料,铜箔,PP片(树脂+玻璃纤维布)。
1.铜箔
铜箔表面在显微镜观察,并不是光滑的,是具有一定粗糙度的,见下图
高速信号传输受趋肤效应的影响的,信号会趋向表面。这样铜皮的粗糙度就会影响信号的质量。目前铜皮的处理方法中常见的有:常规铜(STD)、反转铜(RTF)、超低表面粗糙度(HVLP)、压延(RA)、极低粗糙度(ULP)等。详细的介绍,可以参考笔直之前的文章;详细介绍粗糙度都信号质量得影响
2;PP片(玻璃纤维布浸以环氧树脂组成)
半固化片的工艺原理:
半固化片(prepreg或pp)的工艺原理:Pp是经过处理的玻纤布浸渍上树脂胶液,再经过热处理(预烘)使树脂进入B阶段而制成的薄片材料。而压板的工艺原理是利用半固化片从B-stage向C-stage的转换过程,将各线路层粘结成一体。半固化片在这一过程中的转换过程的状态变化如下图:
A阶段:在室温下能够完全流动的液态树脂,这是玻纤布浸胶时的状态(液态的环氧树脂,又称为凡立水(Vamish))
B阶段:环氧树脂部分交联处于半固化状态,在加热条件下,又能恢复到液体状态。(部分聚合反应,成为固体胶片,是半固化片) pp
C阶段:树脂全部交联为C阶段,在加热加压下会软化,但不能再成为液态,这是多层板压制后半固化片转成的最终状态。(压板过程中,半固化片经过高温融化为液体,然后发生高分子聚合反应,成为固体聚合物,将铜箔与基材粘结在一起。成为固体的树脂)

由于树脂介电常数通常为3-4之间,玻璃纤维的,介电常数为6-7之间,会导致信号有不同的参数影响信号的速度,尤其对高速差分信号较为严重。如下图:
详情可以了解看笔者之前关于玻纤效应对差分信号的影响文章:
详细介绍玻纤效应带来得影响

半固化片(PP)参数:
下图为:建滔板材TG170板材的截图。

1)TG值
Tg: class transition temperature,也就是玻璃态传化温度(对过孔的影响最大),玻璃态转化温度是聚合物的特性,是指树脂从硬(玻璃态)到软(橡胶态)的形态变化的温度。目前FR-4板的Tg值一般在130-140,而在印制板制成中,有几个工序的问题会超过此范围,对制品的加工效果及最终状态会产生一定的影响。因此,提高Tg是提高FR 4耐热性的一个主要方法。
Tg分类:
普通Tg板材: 130140摄氏度
中Tg板材: 140~150摄氏度
高tg板材:大于170摄氏度(八层以上的PCB板必须用高tg板材)
2)PP片的类型
从下图可以明显看出,不同类型PP片中间空袭间隔不一样,经纱纬纱的宽度不一样导致的。中间的空隙都需要树脂填充的。信号线经过感受到的介电常数也就不一样。
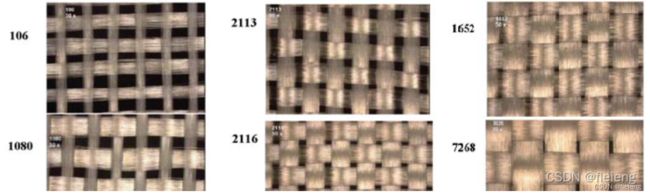

3) RC% (Resin Content)树脂含量:
Pp是增强材料和粘合剂的结合体,对于我们常用的FR4板材来说,增强材料就是环氧玻璃纤布,粘合剂就是环氧树脂,那么RC的值就是我们覆铜板绝缘材料中除了补强材料玻纤布外,其余树脂所占重量百分比。RC含量的多少,直接影响到树脂填充导线间空隙的能力,同时决定压板后的介电层厚度。
4)RF%(Resin flow)胶流量压板后,会有一部分树脂流出板外,那么RF%的值就是流出板外的树脂占原来半固化片总重的百分比,RF是反应树脂流动性的指标,决定了压板后的介电层厚度。
5)** YC%**半固化片经过干燥后,失去的挥发成分的重量占原来重要的百分比。VC%的多少直接影响压板后的品质。
6)DK值,PP片的介电常数,准确的来说是玻璃纤维和树脂混合之后的介电常数,计算公式为:
DK=6.01-3.34R R:树脂含量%
材料的介电常数,只有降低dk才能获得高的信号传播速度。
7) Df:
材料的介质损耗角越低信号传播损失越少。